Spectroscopic Ellipsometry
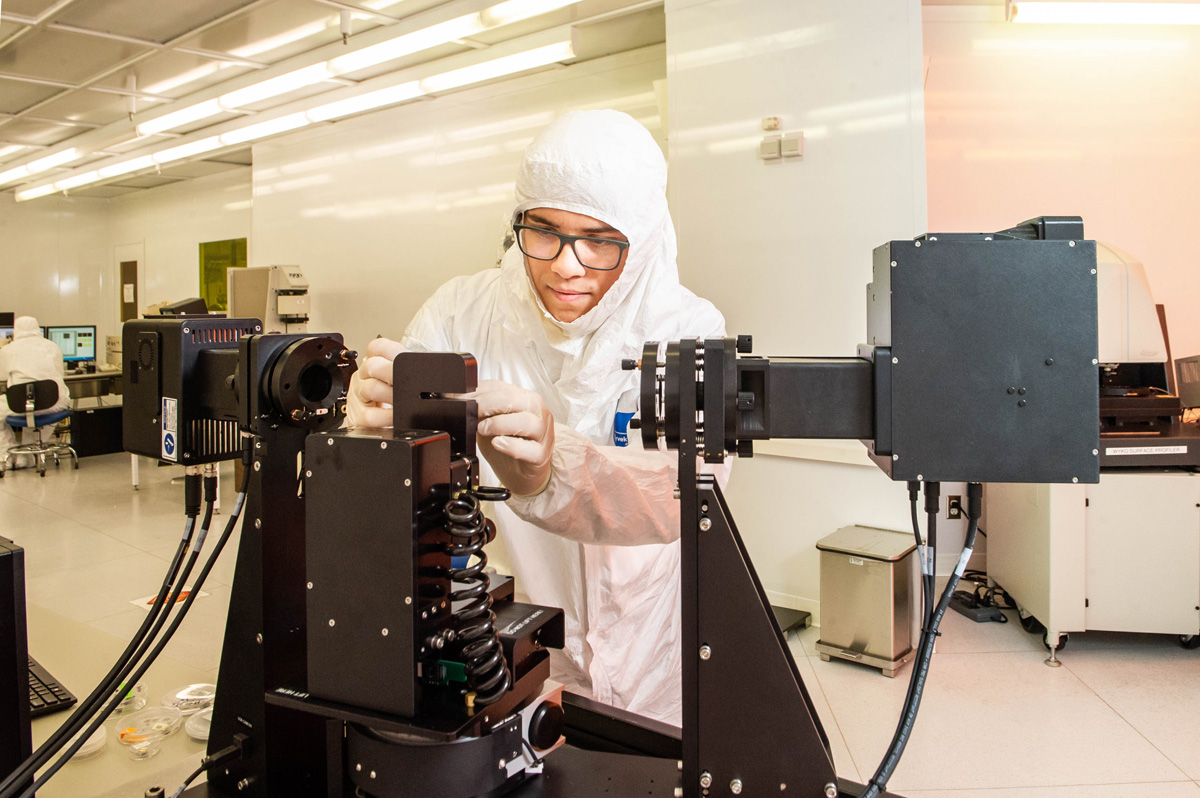
J.A. Woollam RC2 Ellipsometer
Ellipsometry measures the change in polarization as the polarized light interacts with the sample structure. The data is then analyzed to determine material properties like film thickness, optical constants, refractive index, etc. The RC2 ellipsometer is a tool with a unique capability of collecting all 16 elements of the Mueller matrix. Mueller matrix SE allows characterization of the most advanced samples and nanostructures.
For information on how to become a user of the NFF and request training for use of this tool, please send an email to Shaloma Malveaux
If you would like to send samples to us for measurement services, please complete theThin Film Measurement Request Form
J.A. Woollam IR-VASE Mark II
The IR -VASE is a spectroscopic ellipsometer that combines the chemical sensitivity of FTIR spectroscopy with thin film sensitivity of spectroscopic ellipsometry. This tool covers a wide spectral range from 1.7um - 30um (333 cm -¹ - 5900 cm -¹)
Features:
- High Sensitivity to Ultra-Thin Films
- Non-Destructive Characterization
- No Baseline or Reference Sample Required
- Temperature range: 77K - 350°C
For information on how to become a user of the NFF and request training for use of this tool, please send an email to Shaloma Malveaux
If you would like to send samples to us for measurement services, please complete the Thin Film Measurement Request Form